作者: 陶源amao_eda365 2020-02-24
SiP为System in Package 缩写,中文:系统级封装。网上关于它的描述资料非常多,如SiP应用上最成功的应是水果的各类消费类产品。百度上关于SiP的说明各有各的说法:如:几颗芯片封装在一起;一颗芯片加几个电阻电容;不同的角度看都算是SiP,因而无需太纠结。关于SiP的组合方式有:平铺、堆叠、埋入、POP、PIP、AIP/AOP等。
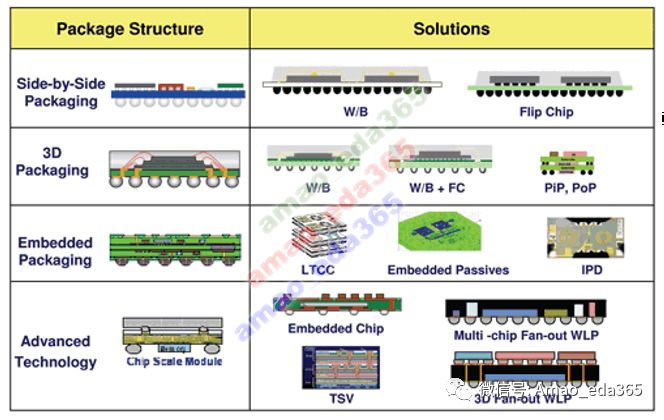
图1 SiP的组合方式
SiP技术的优势及特点
使用SiP技术的产品集成化技术可以实现更低的成本,更高的性能,最关键的是可以给系统集成商提供turnkey方案(这个是核心技术)。这些优势使得SiP技术得到了广泛的应用,如量大的应用情景则用到它的模块化设计;终端则用到它的小型化优势。高密的产品用到它的提升模块性能。

图2 SiP应用情景
SiP的主要优势如下这些点:
(1)产品小型化:
(2)模块化设计
(3)降低系统成本
(4)模组兼容设计
(5)提升模组性能
(6)降低封装成本
(7)提升保密性
(8)减体和减重
SiP虽然有前面提到的各种优势,当然也有它的一些不足及设计制造上的挑战):
(1)裸Die的获取和测试(DC/AC测试,程序烧录等)
(2)封装EMC问题
(3)封装散热
(4)封装测试
(5)组装的精度及可靠性(Die Thickness,Bump Pitch)
(6)生命周期(芯片周期2-3年)
SiP Vs SOC
提到了SiP,有必要提SOC(System on Chip),毕竟如下图大名鼎鼎的摩尔定律是对SOC而言的,而SiP又被称为超摩尔定律(More Than Moore),因为随着芯片工艺极限的接近,使用SiP可以使此定律得以延续。
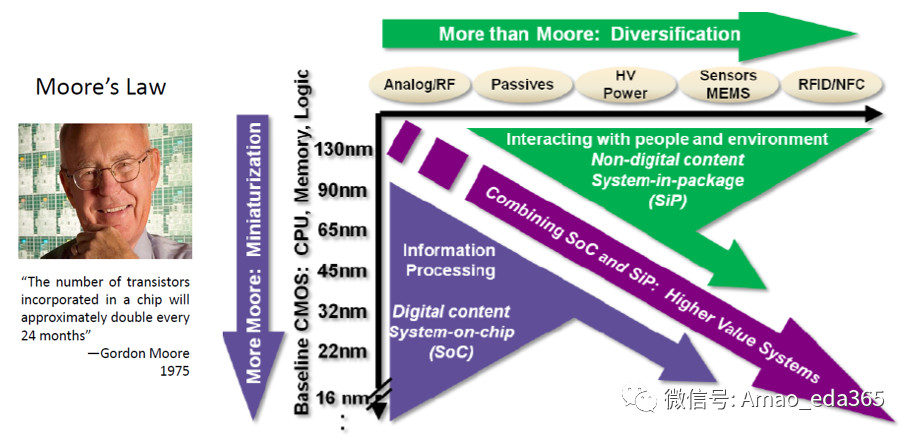
图3 Moore Law
常有人问:SOC和SIP哪个更好?这只能说,没有最好、只有更好、大家好才是真的好。SOC集成度高,可靠性好,那为什么有些芯片用SiP而不用SOC呢,那是因为SOC也它的不足,具体的比较如下表:
表1 SOC与SiP比较
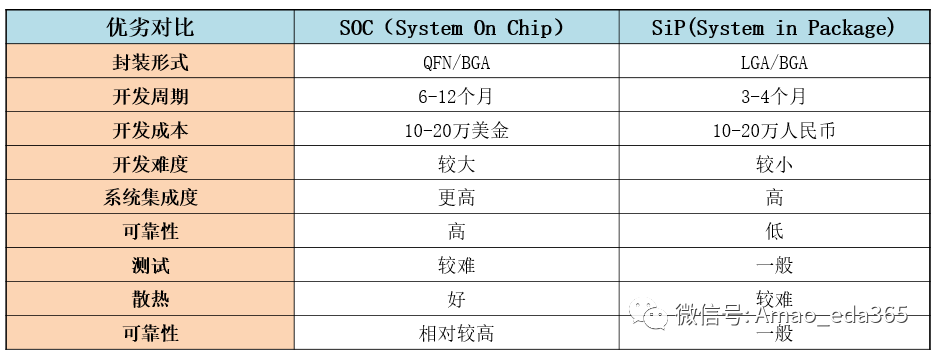
要了解SOC有哪些不足,SiP又有什么优势,需要从芯片工艺、设计、封装的工艺和结构等方面进行深入说明。
材料与工艺
材料有不同,工艺也不相同,如Si/Ge、GaN、InP、SiC等他们的特点与状态如下:
表2 材料及工艺比较

电子产品中用到不同功能芯片,针对这些功能芯片,不同的工艺,不同的制程,生产出来的芯片在性能及应用领域与上市明显不一样。如下面的射频芯片的规划与应用领域图。
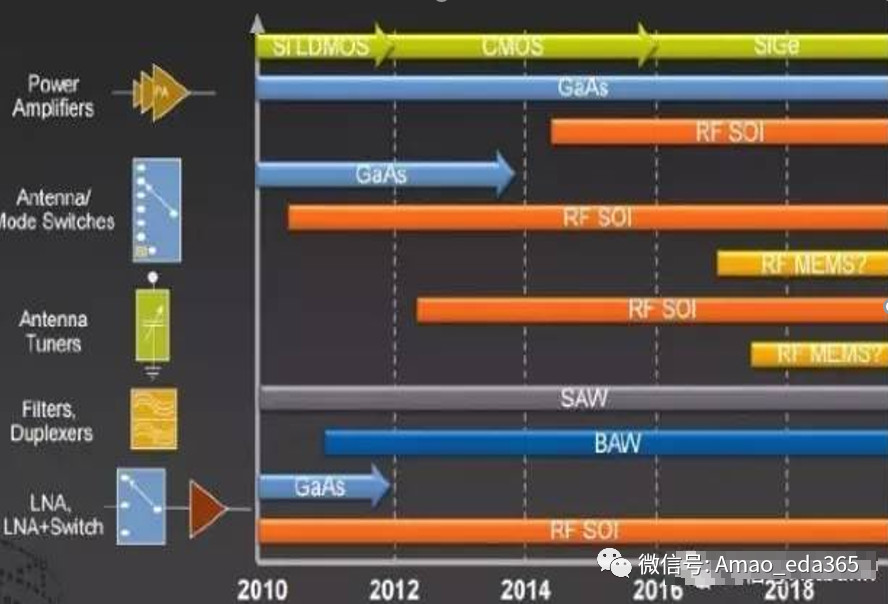
图4 射频芯片的规划与应用领域
芯片材料和工艺的不同,其电子迁移速率,击穿电压、截止频率、功率消耗等均表现差异。如目前射频芯片市场主要分为两大类,一类是使用MEMS工艺制造的滤波器,以SAW和BAW为代表,另一类是使用半导体工艺制造的电路芯片,以PA和Switch为代表。PA通常使用GaAs HBT工艺制造,Switch使用GaAs pHEMT或SOI工艺。随着5G技术日益成熟,未来传统的LDMOS PA制程将逐渐被新兴的GaN取代。
因而:不同工艺技术的应用使得模组集成严重依赖先进封装技术。
即可以在SiP中根据需求组合出不同工艺芯片的产品,而组合完成的SiP在外表看与普通的几乎一样!
芯片工艺也一样。晶体管中PN结的制程,既可以通过电镀慢慢长上去,也可以先直接做好,再慢慢通过蚀刻的方式减下来。不同的方法,做出来的芯片,在成本,性能上必会有差异,就看是否能符合客户的需求了。
如:功放芯片用不同的工艺生产,性能指标肯定不一样;当然了,客户不一样,需求也不一样;或者A客户要求不高,只需要一个简单,指标要求不严格的芯片;而B客户则对指标要求高,对成本不太计较。这就好比市场上不同品牌的手机:苹果,华为,小米,还有360,魅族,TCL,格力等总有它的消费群体一个道理。
SiP封装集成
SiP封装会集成不同的有源/无源元件、各种基板线框等,如下图:
 图5 SiP封装集成元素
图5 SiP封装集成元素
无源元件包括各种分立元件,有源器件则为各种裸Die等。
基板则有:有机,陶瓷,金属等;
如要集成电感时:可以用分立器件,也可以用IPD器件,也可以集成到基板上,也可以用Wafer工艺做到芯片里面。但做到芯片里面,电感值越大,DIE中占面积就越大,芯片面积增大,成本就会增加,同时,集成到芯片里面,干扰也越大,芯片开发的难度就越大。同时,大电流对芯片的可靠性的影响,这些都需要考虑。同一个感值的电感,用不同的工艺来做生产,分立器件成本是最低。再有就是分立器件更灵活,有些感值的电感,用芯片还不一定能做的出来,因为电感与的圈数(决定感值),同流(线径)等有关,这些晶圆的走线与分立器件的绕线不在一个数量级。
所以,针对SIP和SOC:
1、如果能用一种工艺来实现, SOC比较有优势
2、如果需要多种技术和工艺集成,SiP 最佳
SiP与SOC方案选取
SiP和SOC也不矛盾,SOC发展也促进了SiP的发展。例如驱动通流,Rds减少,芯片集成度,匹配,ESD防护等等。Memory颗粒的容量增大。芯片的功能集成度提升,系统的架构升级等等。同时 SiP的实现也可以变相地提前规避SOC设计中的风险。拆开来开发,可减少芯片的开发难度和投入。
1、混频器中应用的Balun方案
(1)直接集成到Mixer芯片内,比如Maxim ;
(2)采用陶瓷Balun,再表贴到基板上的,比如RFMD;
(3)采用基板Embedded的方式直接在基板上实现的,比如Skyworks;
(4)直接在产品PCB上实现,比如HUAWEI。
2、BLE和WIFI方案
(1)有厂家都是单独一颗颗的器件,在PCB上贴两颗IC;
(2)有厂家采用SiP技术封装到一个模组内;
(3)有厂家直接做成一颗SOC,尺寸做得更小。
不同的厂商采用不同的设计,当然,在成本和性能上也有一些差异,这个就看客户的指标要求和成本要求了。
方案选取时还需要好了解工艺制程、成本、良率、公司的设计人员是否有掌握了工艺能力,是否掌握了设计能力,能不能找到资源把设计的芯片加工出来、良率、交期、成本等是否满足要求,除了技术上的因素,还有很多商务上的,或者是政治上的(比如现在的中美贸易战)等不同的因素。
MCM
与SiP常混淆的另一个概念为MCM(Multi Chip Module)多芯片模组,一般认为MCM是SiP的前身。MCM多是针对成片的模组而言,现在MCM用在陶瓷基板封装的比较偏多。当然,这个没有绝对,SiP和MCM也没有严格去划分,采用成片和基板封装成一个模组,如果模组尺寸比较对称,能用于直接SMT,就不需要用于贴片机贴片,如果Module不利于贴片机的吸嘴,可以考虑加一个LID,或者是MOLD起来,外观看起来就是一个封装器件了。
不同公司的对SiP的称呼不一样,这也不排除蹭热点的可能。比如,Skyworks的资料中把SIP全部归纳到MCM,不管是成片还是裸片。但相同类型的器件,TQS(现在的Qrovo)则称之为SiP。ADI也称之为SiP.
当然了,除了封装的称呼的区别,Skyworks把封装用的Substrate也称之为PCB,在Skyworks的资料里就没有substrate这个名词(也有可能非常专业人士干的活,刚好这块不复杂)。正如周总在《唐伯虎点秋香》中说的“名字只是一个代号”,不必太认真。
SiP是一门综合多学科的技术,它涵盖了电路、电磁、材料、力、热等。要做好SiP产器,必须要从产品设计、系统架构、硬件设计、封装设计、封装组装、测试、可靠性、成本和供应链等方面进行综合的考虑。
针对SiP,建议关注学习下图的相关知识与技能:
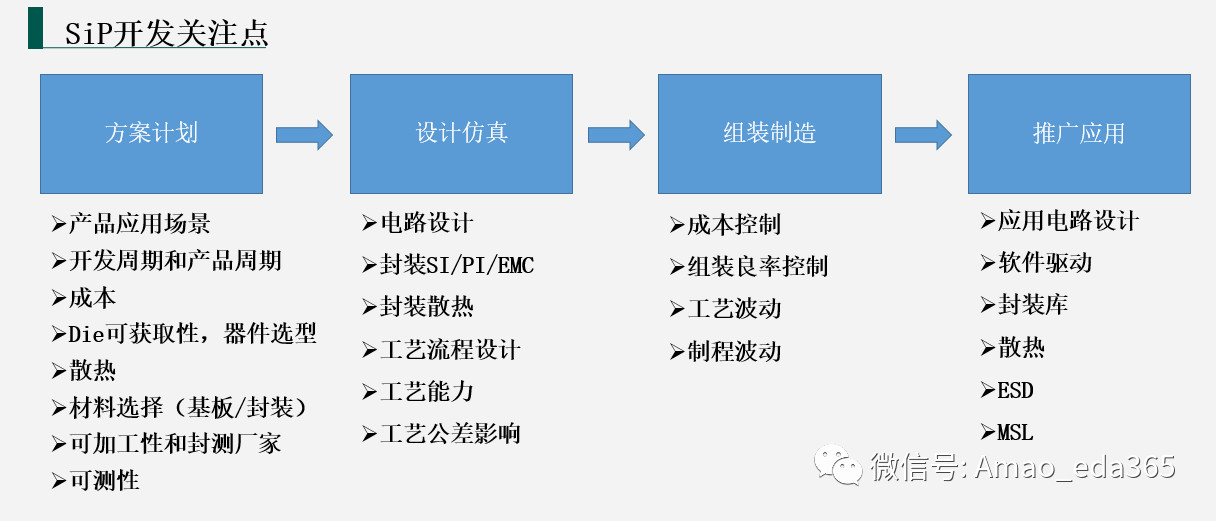 图6 SiP开发关注点
图6 SiP开发关注点
因而,做SiP要学的知识很多,系统考虑很关键。
如下面的相互关系,每一个阶段都与下一个阶段密切相关。
(1)应用决定了模组的量产
(2)制造决定了模组的成本
(3)设计决定了产品的性能
(4)方案决定了项目的成败
一个SiP项目,哪一步最重要?当然方案是最重要的。采用哪种方案(平铺?堆叠?埋入式?采用哪种工艺?),集成哪些器件(哪些功能?哪个厂家,哪种形式),采用哪种封装(LGA?BGA? POP?),Pinmap(信号管脚排布,测试管脚引出,外围电路与内部对应),封装工艺流程及其加工验证计划等等。这些都是我们需要在方案确定是需要明确的,也就是我们系统级封装的核心。
这些东西可能在最初的方案及其立项阶段不一定能完全确定,在实际项目开展过程中可能还需要进行变更。但是变更的时候,一定要思考其变更对其他领域带来的影响,这些技能需要长期的学习与积累。
SiP:System in Package :“系统级”封装,系统是SiP与常规的Package最大的差异,没有System意识,谈不上懂SiP;最多算是封装工艺工程师,或者是封装Layout工程师。
注:原创作者是陶源amao_eda365

扫码关注米客方德
大陆:深圳市南山区深圳国际创新谷1栋A座202
邮编:518055
电话:0755-26900702
邮箱:mk@mkfounder.com